在AI算力爆发的当下,传统电子互联逐渐逼近物理极限,如何实现更高速、更低功耗的数据传输成为全行业焦点。在这一背景下,硅光子技术(Silicon Photonics)逐步从实验室走向商用前沿,成为AI硬件体系架构革新的关键引擎之一。
硅光子技术通过将光电组件(包括激光器、调制器、光探测器、波导等)与传统CMOS工艺融合,实现在硅基晶圆上的光子集成电路(PIC)制造。相比传统铜线互联,光互联在数据中心和AI计算场景中展现出低功耗、低延迟、高带宽等多重优势,尤其适用于处理日益增长的模型参数和海量数据传输需求。
与此同时,产业巨头如TSMC、NVIDIA、ASE等正在加快对硅光子与共封装光学(CPO)技术的投资布局。COUPE平台、Optical Engine(OE)、3D封装等技术路线正推动硅光子走向大规模应用,而背后的Foundry、封测、器件、材料等环节也逐步形成完整生态体系。
AI时代的光电融合已不是愿景,而是趋势。硅光子技术正处于由“能不能做”迈向“做得起”“用得上”的关键转折点,其产业化节奏与生态构建将深刻影响下一代AI硬件的性能边界与算力形态。
一、技术基础:硅光子的定义与核心组成
硅光子技术的本质在于利用硅基材料进行光信号的调制、传输与探测,并将其集成于标准CMOS工艺流程中。这种架构通过将光子器件(Photonic Integrated Circuit, PIC)与电子器件(Electronic Integrated Circuit, EIC)共同封装,形成一体化的系统级芯片(SoIC),构建出具备三维封装能力的光电融合平台。

在具体组成上,硅光子芯片通常包含四大核心模块:激光光源、调制器、光探测器以及波导系统。其中,波导用于引导光信号在芯片内传播;调制器(如MZM、MRM)用于对电信号进行光调制;探测器一般采用锗(Ge)材料,实现对光信号的高效接收;而激光器则提供通信所需的光源,常用材料包括InGaAsP/InP等III-V族化合物。

不同光源材料所覆盖的波段各异,决定了其应用场景。例如,850nm波段适合短距通信,但损耗大,不适合长距离传输;而1260nm~1625nm被认为是“低损耗窗口”,是电信级光通信的主力波段(来源:第6页)。波导部分则基于SOI(Silicon-On-Insulator)结构,具有亚波长尺寸设计,借助高折射率差实现高效率光信号引导。
硅光子的制造也高度依赖晶圆厂的特殊工艺能力。以调制器为例,其性能受掺杂剂量控制;而锗探测器则需配套Ge CVD沉积、刻蚀、形貌控制等流程;波导的设计则对圆角、几何结构等细节要求极高。这些工艺特征决定了硅光子技术无法完全套用逻辑芯片的制程,而需要Foundry厂进行专门适配与平台建设。
综上,硅光子技术虽然底层基础在于硅材料和CMOS工艺,但其对材料工程、光电设计、器件结构的要求极为复杂,是一门跨越物理、材料、工程、微纳制造的系统性技术。正是这项技术,为AI时代提供了突破传统互联瓶颈的希望路径。
二、先进封装:从2D到3D的演进
随着硅光子集成度和带宽需求不断提升,传统2D封装架构已难以支撑高性能光电系统的互联需求。因此,封装技术正迅速向2.5D与3D架构演进,成为硅光子规模化落地的关键一环。
在2D封装架构中,光电芯片(PIC)与电路芯片(EIC)被水平排列于同一基板上,通过线焊或覆晶方式连接,结构相对简单,适合成本敏感型应用。然而这种布局难以满足高带宽、高密度互联需求,线长、延迟、功耗成为限制因素。
2.5D封装则通过将PIC与EIC覆晶封装在同一中介层(Interposer)上,由中介层完成二者之间的金属互联,大幅提升连接密度与信号完整性。这种方案已经被广泛应用于中高端通信模块和数据中心交换机芯片上,是硅光子系统的主流过渡方案。

而3D封装代表着当前最先进的互联架构,它通过硅通孔(TSV)、重布线层(RDL)、键合凸块等技术手段,将光子芯片直接作为中介层,电路芯片垂直堆叠其上,实现真正的垂直光电互联。这种方式显著缩短互联路径,降低能耗,提高信号速度,同时提升系统封装密度,成为推动CPO系统实现超高带宽(如1.6T以上)的核心技术路径。
总体来看,封装技术已成为决定硅光子系统能否商用化的“最后一公里”。特别是在AI和高性能计算场景中,3D封装不再是成本负担,而是通往带宽极限的必要前提。TSMC、ASE等产业巨头正积极推动这一方向的落地,推动封装从支撑角色走向系统性能主导力量。
三、TSMC COUPE平台解析
在硅光子规模化应用的推进中,台积电(TSMC)构建的COUPE平台成为产业界的重要技术基座。COUPE(Compact Universal Photonic Engine)平台不仅集成了硅光子光引擎(Optical Engine, OE),还整合了光学耦合器、复合中介层与三维封装技术,构成高度集成的异质光电协同系统。
COUPE平台的核心架构为“iOIS”(Integrated Optical Interconnect System),通过垂直宽带耦合器(BBC)连接光引擎与中介层,支持OE模块与逻辑芯片之间的高速光电互通。该平台使用OE作为光互联核心,具备紧凑结构与高带宽特性,支持1.6T起步、未来可拓展至6.4T乃至12.8T,是面向下一代AI计算与光通信系统设计的关键基础设施。
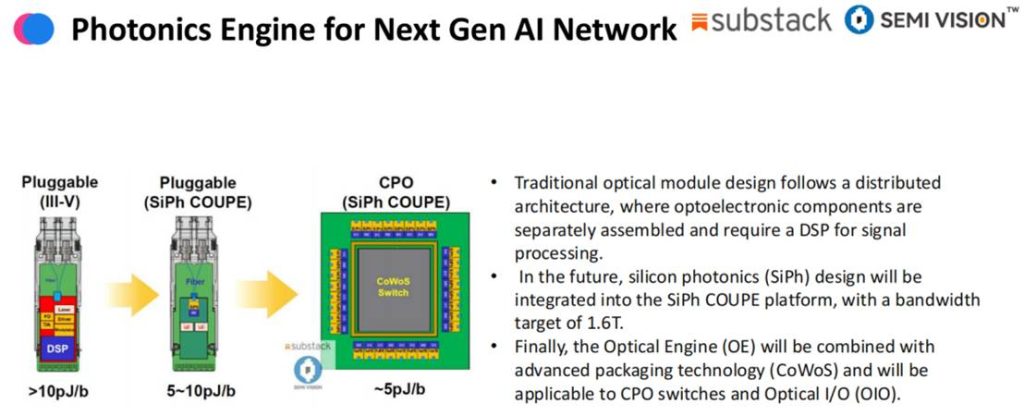
在封装路径上,TSMC将3D封装工艺(如SoIC-X)应用于OE模块,实现PIC与EIC之间的垂直混合键合。这种方案较传统2.5D互联具有更高的带宽密度与更优的功耗控制能力。未来该技术也可与台积电CoWoS、InFO等封装平台兼容,实现系统级集成。
为实现高效光耦合,COUPE平台还提供两种耦合方案:Grating Coupler(COUPE-GC)与Edge Coupler(COUPE-EC)。GC方案兼容晶圆级测试与大规模制造,适合Foundry厂大批量导入;而EC方案则具备更高耦合效率与更宽带宽,适合实际部署场景但在制造与装配中需更高精度。多数晶圆厂倾向COUPE-GC,而系统方案商与模块厂则更偏好COUPE-EC。
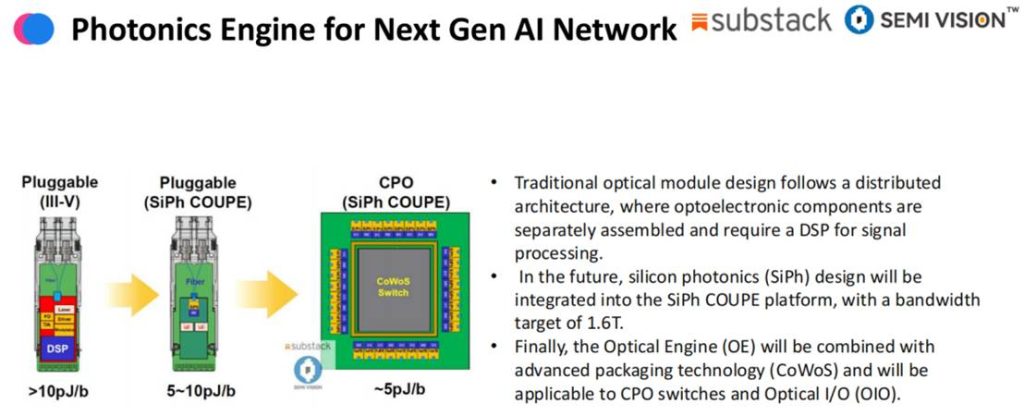
台积电的CPO技术蓝图也明确给出了时间节点:2025年推出1.6T OE模块,2026年推出6.4T用于交换芯片(Switch ASIC),2027年后推出12.8T面向xPU等高性能计算核心。这一节奏表明,COUPE平台将是未来五年内推动硅光子落地的主力平台,并可能重塑AI芯片封装架构。
总的来看,TSMC COUPE平台不仅是Foundry层对硅光子的战略响应,也是其先进封装能力与异质整合技术的系统体现。它提供了一种从材料、器件、封装到系统完整闭环的工业平台,标志着硅光子从“研发课题”向“量产平台”跃迁的关键节点。
四、CPO架构与关键应用场景
共封装光学(Co-Packaged Optics, CPO)正成为AI与高性能计算系统中最具前景的互联技术之一。其核心在于将光子器件与计算芯片(如GPU、xPU或交换ASIC)在同一封装中集成,消除长距离铜互联带来的能耗、延迟与信号完整性问题,从而构建真正面向AI时代的高效数据传输架构。
传统光模块架构采用“分布式设计”,光电元件与DSP信号处理芯片分别封装,再通过PCB连接,存在功耗高、延迟大、集成度低等问题。CPO架构则将光引擎(OE)直接集成至计算平台核心,通过短距、高带宽、低能耗的光链路完成芯片间通信,典型带宽目标可达1.6T/6.4T/12.8T。

在实际部署层面,CPO技术已被用于构建下一代交换机与光I/O接口。尤其在大型数据中心、AI集群、高速互联场景中,CPO具备四大关键价值:
- 高带宽、低延迟:直接连接主芯片,省去长距离SerDes与DSP转化,极大提升互联效率。
- 降低功耗:支持每bit传输功耗低至5pJ以下,远低于传统铜缆系统。
- 模块集成化:系统模块小型化、信号路径缩短,有利于散热与部署。
- 支撑AI/ML负载:满足日益庞大的模型规模与训练需求,特别适合xPU架构。
CPO的典型应用还包括:
- 数据中心交换机(Switch with OE)
- AI训练集群之间的高速互联(xPU to xPU)
- 云服务商的大规模光通信模块部署(CSP Optical Modules)
- 5G前传/回传网络(O-RAN架构)等
此外,CPO也改变了传统光通信产业链的模块分工。由于OE需与计算芯片深度协同,其设计制造不再由独立模块厂主导,而需Foundry、IC设计公司、封装厂协同完成。这种“计算-互联协同设计”的范式,正引领下一波封装创新风潮。
因此,CPO不仅是硅光子的一种封装形态,更是下一代AI系统架构的互联底座。它连接的不只是光与电,更是芯片与系统、算力与带宽之间的鸿沟。
五、NVIDIA与CPO:为何选择共封装光学?
作为AI算力生态的引领者,NVIDIA在CPO技术上的战略布局无疑具有风向标意义。面对不断扩张的模型规模与GPU间通信瓶颈,NVIDIA选择拥抱CPO架构,正是为了从底层打通其高性能计算平台中的“内存墙”与“互联墙”。
CPO技术为NVIDIA带来五大关键优势:
- 极高带宽
在AI模型训练过程中,节点间需频繁交换梯度与参数,传统SerDes链路难以支撑如此密集的数据传输需求。通过CPO架构,NVIDIA可以直接将OE模块嵌入GPU封装内,实现数Tbps级的光互联,为后续1.6T/6.4T/12.8T的AI系统构建提供硬件基础。 - 低延迟、高实时性
对于如GPT-4级别的模型推理与训练,毫秒级通信延迟都会带来明显性能下降。CPO以光链路代替长距离电互联,显著降低互联延迟,提升系统响应速度,是实现大规模AI并行的重要保障。 - 能耗控制与热管理优化
高性能GPU系统的散热压力极大。CPO通过缩短互联距离、取消传统光模块,能有效降低通信功耗,辅以先进封装架构,也更易于整体热设计,从而增强系统稳定性。 - 可扩展性强
面对从400G/800G向1.6T甚至更高演进的网络带宽需求,CPO具备更优的拓展路径。NVIDIA规划的CPO方案具备模块化扩展能力,既适用于单卡互联,也适用于GPU阵列或节点间的超大规模组网。 - GPU深度整合
与传统外挂光模块不同,CPO能将OE直接集成入GPU或交换芯片本体内,从而实现“封装级协同优化”,为下一代xPU在IO能力上的突破打下基础。

在制造端,NVIDIA也联合TSMC、ASE等供应链伙伴,通过SoIC-X等3D封装工艺推动OE模块的集成落地。这种深度异质整合策略,标志着CPO已从“互联技术”转变为“系统架构核心”,也为整个AI硬件产业提供了可借鉴范式。
总体而言,NVIDIA之所以坚定投入CPO,是因为在其推动的AI算力革命中,系统互联已成为新的性能瓶颈。CPO正是突破这一瓶颈、实现AI算力进一步跃升的关键路径。
六、硅光子产业链与联盟生态
硅光子技术的快速演进不仅依赖前沿设计与制造能力,更需要一个协同、高效的产业生态体系。从材料与器件研发,到晶圆代工、先进封装,再到光通信模块与系统应用,硅光子的商业化路径已逐步形成闭环产业链。
整个硅光子生态可大致划分为五大核心环节:
- 上游材料与器件:包括III-V族光源材料(InP、GaAs)、SOI晶圆、Ge探测器工艺等,是实现高性能PIC的物理基础。
- 中游制造与封装:由Foundry负责SiPh器件集成(如TSMC、Intel)、封装厂负责2.5D/3D集成(如ASE、Amkor)。
- 下游模块与系统:系统厂商(如NVIDIA、Broadcom)将OE模块整合至计算平台,或为CSP提供大规模光模块。
- 测试与耦合:包括OE模组的良率测试、Grating/Edge耦合效率调校,是确保产品可靠性的关键节点。
- 应用终端:涵盖AI计算、数据中心、5G通信、光I/O等新兴场景,对系统性能和可靠性要求极高。
为了整合产业资源、推动标准共建,SEMI(国际半导体产业协会)牵头成立了“硅光子产业联盟”,并由TSMC与ASE担任共同主席单位,联合全球80余家上下游企业参与。这一联盟不仅提供技术交流平台,也推动了测试标准、封装接口、模块接口协议等关键基础设施的建立。
值得注意的是,硅光子的产业生态明显偏向“系统驱动”,即终端应用(AI芯片、数据中心)反向牵引上游技术发展路径。这种模式区别于传统光通信产业,更加注重封装集成、协同设计与生态闭环能力。
此外,各大Foundry厂如TSMC、Intel、三星等也纷纷推出自己的CPO技术路线图,从工艺平台、封装接口到带宽目标逐步标准化,推动硅光子由“高度定制”走向“平台化”制造。
可以说,硅光子的成熟不再只是某家企业的能力体现,而是整个行业链条的协同成果。只有产业生态稳定,才能支撑这项技术走出实验室,真正嵌入每一台AI计算平台之中。
七、发展瓶颈与未来展望
尽管硅光子技术已在多个核心场景中展现出巨大潜力,并获得TSMC、NVIDIA等关键玩家的推动,但其规模化部署仍面临多重挑战。要真正实现商业化落地,技术、产业与生态三个层面仍需同步突破。
首先,制造复杂性是CPO架构的核心技术难题。硅光子系统需要在一颗芯片中集成激光器、调制器、波导、探测器等多种异质器件,涉及III-V族材料、Ge掺杂、亚波长波导设计、键合工艺等多个高精度工艺节点,远超传统CMOS逻辑工艺的工艺复杂度。其中SoIC混合键合(如TSMC SoIC-X)虽提供了解决路径,但对设备、良率和工艺稳定性提出了极高要求。
其次,热管理问题制约CPO进一步集成。随着OE模块贴近计算核心(如GPU、ASIC)封装,功耗密度上升,芯片间热耦合加剧,传统散热方案难以满足3D封装中对温度梯度的控制要求。这不仅影响系统稳定性,也可能导致性能下降或信号偏移。
第三,产业采用速度仍有待提升。虽然顶层厂商已开始部署,但CPO模块整体成本高昂,产业链标准化不足,平台之间接口互通性较低,加之测试环节复杂,使得大规模部署进度滞后于技术成熟度。中小型厂商在设计导入、封装适配与测试验证方面仍面临较高门槛。
然而,从中长期来看,CPO和硅光子的成长空间依然巨大。根据TSMC技术路线图,其将在2025年量产1.6T OE模块,2026年推出6.4T模块用于交换芯片,2027年进入12.8T阶段,支持更高级别的AI系统组网需求(来源:第18页)。这一节奏也被NVIDIA等终端厂商采纳,预计其首批集成CPO的高性能GPU平台将在2025年面世。
展望未来,硅光子将在三个方向形成突破性价值:
- AI互联主干:作为GPU/xPU之间通信的高速主干,为AI系统从百卡向千卡集群扩展提供底层支撑;
- 数据中心网络重构:在交换机、光IO等模块中大规模替代电互联,重构数据中心架构;
- 标准化模块平台:通过联盟推动产业标准建立,使硅光子成为通用平台能力而非定制化方案。
硅光子的价值不在于“替代铜线”,而在于“重新定义连接”。随着技术瓶颈逐步被产业协同化解,硅光子将在AI时代从通信边缘走向系统核心,成为构建下一代高性能计算平台不可或缺的一环。
